近年、基板実装での「高密度化」「3次元実装」「小型化」などのキーワードを耳にすることが多いのでは
ないでしょうか。これらのキーワードに大きく関わっている技術がTSVとTGVです。
TSV(Through-Silicon Via)とはシリコン貫通電極のことで、TGV(Through-Glass Via)はガラス貫通電極の
ことです。
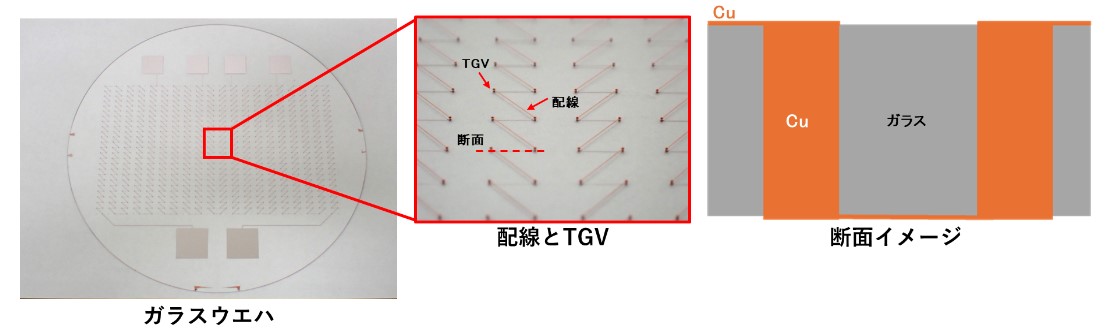
シリコンウエハ/ガラスウエハに貫通via(貫通孔)を開け、内部をめっきで埋め込むことで、ウエハの内部に
配線を形成でき、ウエハの上下で電気を通すことができるようになります。
これによって、チップ同士を、従来の基板の平面で配線をつなぐレイアウト(ワイヤーボンディングや
はんだ実装)から、チップを上下に重ねて配線をつなぐレイアウトに変えることができるようになります。
上下三次元に基板を実装でき、回路の高密度化が可能になります。
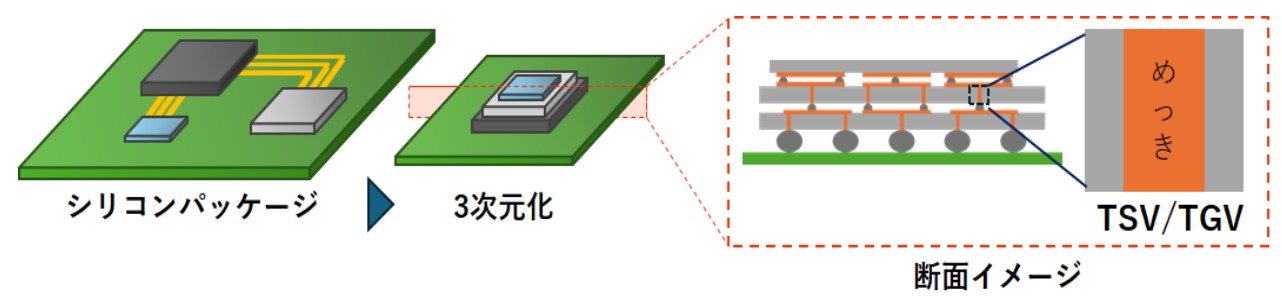
viaへのめっきは一般的にはCu(銅)めっきで行います。
数ある金属の中でも、Cuは電気をよく通す特性(電気伝導率が高い)があるためです。
viaへのめっきの方法としては2種類あります。
1つ目は、前述したようなvia内を完全にCuめっきで埋め込むフィリングめっきです。
2つ目は、viaの壁面のみをめっきで覆い、内部の充填までは行わない、コンフォーマルめっきです。

フィリングめっきの場合、Cuが充填されているのでviaサイズに応じて大きな電流を流すことができるメリットがあります。一方で、充填するのに時間がかかる点や、埋め込むviaの設計によって、非常に高い埋め込み技術が
必要となります。
対して、コンフォーマルめっきは、Cuが薄く壁面にのみ析出しているため、あまり大きな電流は流せません。
しかし、フィリングめっきよりも形成にかかる時間が短く、また、形成難易度も低くなります。
よって、流す電流があまり大きくない場合、コストを抑えたい等などによって、コンフォーマルめっきを
検討いただく場合もございます。
当社では、どちらのめっき方法も行っております。
特に、現在主流の貫通viaのフィリングめっきは多くの処理実績がございます。
TSV/TGVへのめっきにお困りでしたら是非当社へお問い合わせください。
様々なTSV/TGVへのめっき実績を活かしたご提案をさせていただきます!